koda QR

Izdelki
Kontaktiraj nas


faks
+86-579-87223657

E-naslov

Naslov
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Kitajska
Pri prikazih polprevodnikov in na plošči FPD je priprava tankih filmov pomemben postopek. Obstaja veliko načinov za pripravo tankih filmov (TF, tanek film), naslednji dve metodi sta pogosti:
● CVD (kemično naparjanje)
● PVD (fizično odlaganje hlapov)
Med njimi so v komori naprave s pomočjo PECVD v komori naprave nalagani pufer/aktivna plast/izolacijska plast.
● Uporabite posebne pline: SiH4/NH3/N2O za nanašanje filmov SiN in Si/SiO2.
● Nekateri CVD stroji morajo za hidrogenacijo uporabiti H2, da povečajo mobilnost nosilca.
● NF3 je čistilni plin. V primerjavi: F2 je zelo strupen, učinek toplogrednih sredstev SF6 pa je višji kot pri NF3.
V postopku polprevodniške naprave obstaja več vrst tankih filmov, poleg skupnega SiO2/Si/Sin pa obstajajo tudi W, TI/TIN, HFO2, SIC itd.
To je tudi razlog, zakaj obstaja veliko vrst predhodnikov za napredne materiale, ki se uporabljajo v industriji polprevodnikov za izdelavo različnih vrst tankih filmov.
1. Vrste KVB in nekateri predhodniki
2. Osnovni mehanizem CVD in kakovost filma
KVB je zelo splošen koncept in ga je mogoče razdeliti na številne vrste. Pogosti so:
● PECVD: Plazma izboljšana CVD
● LPCVD: CVD z nizkim tlakom
● ALD: odlaganje atomske plasti
● MOCVD: Kovinsko-organski CVD
Med postopkom CVD je treba pred kemičnimi reakcijami krmiljenja kemijskih vezi predhodnika.
Energija za prekinitev kemičnih vezi prihaja iz toplote, zato bo temperatura komore razmeroma visoka, kar ni prijazno do nekaterih procesov, kot je steklo substrata plošče ali PI material upogljivega zaslona. Zato se bo z vnosom druge energije (tvorjenje plazme itd.) za znižanje temperature procesa za izpolnitev nekaterih procesov, ki zahtevajo temperaturo, zmanjšal tudi toplotni proračun.
Zato se v industriji prikazovanja FPD pogosto uporablja PECVD odlaganje A-Si: H/SIN/Poly-Si. Skupni predhodniki in filmi CVD:
Polikristalni silicij/enojni kristalni silicij sio2 sin/sion w/ti wsi2 hfo2/sic
Koraki osnovnega mehanizma KVB:
1. Reakcijski predhodni plin vstopi v komoro
2. vmesni produkti, ki jih proizvaja reakcija plina
3. Vmesni produkti plina difundirajo na površino substrata
4. Adsorbirano na površini substrata in razpršeno
5. Kemična reakcija poteka na površini substrata, nukleacija/tvorba otoka/tvorba filma
6. Stranski produkti se desorbirajo, vakuumsko odčrpajo in izpustijo po vstopu v pralnik za obdelavo
Kot smo že omenili, celoten proces vključuje več korakov, kot je difuzija/adsorpcija/reakcija. Na celotno hitrost nastajanja filma vpliva veliko dejavnikov, kot so temperatura/tlak/vrsta reakcijskega plina/vrsta substrata. Difuzija ima difuzijski model za napovedovanje, adsorpcija ima teorijo adsorpcije, kemična reakcija pa teorijo kinetike reakcije.
V celotnem procesu najpočasnejši korak določa celotno hitrost reakcije. To je zelo podobno metodi kritične poti vodenja projektov. Najdaljši tok aktivnosti določa najkrajše trajanje projekta. Trajanje je mogoče skrajšati z dodelitvijo virov, da se skrajša čas te poti. Podobno lahko CVD najde ključno ozko grlo, ki omejuje hitrost nastajanja filma, tako da razume celoten proces, in prilagodi nastavitve parametrov, da doseže idealno hitrost nastajanja filma.
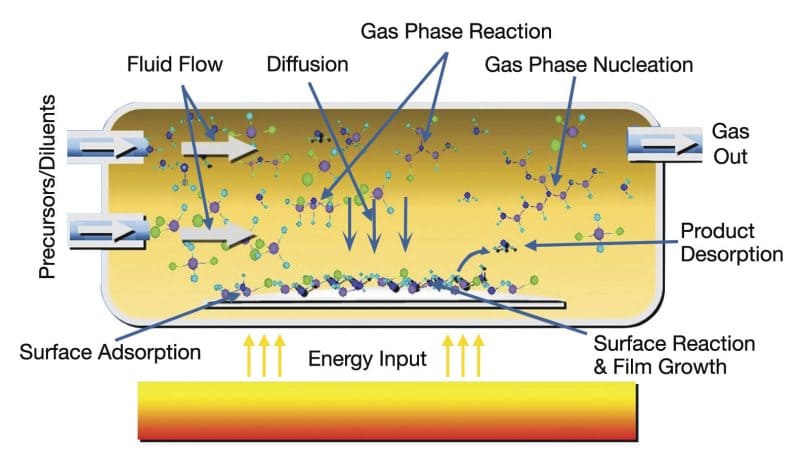
Nekateri filmi so ravni, nekateri so nadeva na luknji, nekateri pa so nadeva z groove, z zelo različnimi funkcijami. Komercialni CVD stroji morajo izpolnjevati osnovne zahteve:
● Zmogljivost obdelave strojev, stopnja nalaganja
● Doslednost
● Reakcije v plinski fazi ne morejo proizvesti delcev. Zelo pomembno je, da ne nastanejo delci v plinski fazi.
Nekatere druge zahteve za ocenjevanje so naslednje:
● Dobra pokritost korakov
● Sposobnost zapolnjevanja vrzeli v visokem razmerju stranic (konformalnost)
● Enotnost dobre debeline
● Visoka čistost in gostota
● Visoka stopnja strukturne popolnosti z nizkim filmskim stresom
● Dobre električne lastnosti
● Odličen oprijem na podlago



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Kitajska
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. Vse pravice pridržane.
Links | Sitemap | RSS | XML | Politika zasebnosti |
