koda QR

Izdelki
Kontaktiraj nas


faks
+86-579-87223657

E-naslov

Naslov
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Kitajska
Silicijev karbid je eden izmed idealnih materialov za izdelavo visokotemperaturnih, visokofrekvenčnih, visokih in visokonapetostnih naprav. Za izboljšanje učinkovitosti proizvodnje in zmanjšanje stroškov je priprava velikih silicijevih karbidnih substratov pomembna razvojna smer. Cilj zahtev procesa8-palčna rast silicijevega karbida (sic), Analiziran je bil mehanizem rasti silicijevega karbidnega fizikalnega transporta (PVT)Tac prevlečeni obroči, Tac prevlečena plošča, TAC, prevlečen s tremi petalnimi obročki, TAC, prevlečen s tremi petalnimi lončki, držalo, prevlečeno s TAC, porozni grafit, mehki klobučeviSIC enojni proces rasti kristalov rezervni delizagotavljajo Vetek Semiconductor), proučevali so tehnologijo rotacijskega rotacijskega rotacije in procesnega parametra za nadzor ene same kristalne peči silicijevega karbida, 8-palčni kristali pa so bili uspešno pripravljeni in gojili z analizo simulacije termičnega polja in poskusi procesov.
Uvod
Silicijev karbid (SIC) je tipičen predstavnik polprevodniških materialov tretje generacije. Ima prednosti uspešnosti, kot so večja širina pasu, električno polje z višjim razpadom in večja toplotna prevodnost. Dobro deluje na visokotemperaturnih, visokotlačnih in visokofrekvenčnih poljih in je postal ena glavnih razvojnih smeri na področju tehnologije polprevodniških materialov. Trenutno industrijska rast kristalov silicijevega karbida večinoma uporablja fizični transport hlapov (PVT), ki vključuje kompleksne težave z več fizikalnimi poljskimi povezavami večfaznih, večkomponentnih, večkomponentnih in masnih prenosov in magneto-električnega toplotnega pretoka. Zato je zasnova sistema rasti PVT težka, merjenje in nadzor parametrov procesproces rasti kristalaje težko, kar ima za posledico težave pri nadzoru kakovostnih napak prirašenih kristalov silicijevega karbida in majhne velikosti kristala, tako da stroški naprav s silicijevim karbidom, ko substrat ostanejo visoki.
Oprema za proizvodnjo silicijevega karbida je temelj tehnologije Silicon karbide in industrijskega razvoja. Tehnična raven, zmogljivost procesa in neodvisno garancijo silicijevega karbida enojne kristalne rastne peči so ključnega pomena za razvoj materialov iz silicijevega karbida v smeri velike velikosti in visokega donosa in so tudi glavni dejavniki, ki poganjajo polprevodniško industrijo tretje generacije, da se razvijejo v smeri nizkih stroškov in velikega obsega. V polprevodniških napravah s silicijevim karbidnim enim kristalom kot substratom vrednost substrata predstavlja največji delež, približno 50%. Razvoj visokokakovostne visokokakovostne opreme za rasti silicijevega karbida, izboljšanje donosa in stopnje rasti enojnih kristalnih substratov silicijevega karbida ter zmanjšanje proizvodnih stroškov so ključni pomembni za uporabo povezanih naprav. Za povečanje ponudbe proizvodne zmogljivosti in nadaljnje zmanjšanje povprečnih stroškov naprav iz silicijevega karbida je povečanje velikosti substratov iz silicijevega karbida eden od pomembnih načinov. Trenutno je mednarodna mainstream silicijev karbid substrat 6 centimetrov in hitro napreduje na 8 centimetrov.
Glavne tehnologije, ki jih je treba rešiti pri razvoju 8-palčnih silicijevih karbidnih enojnih kristalnih peči, vključujejo: (1) zasnovo strukture toplotnega polja velike velikosti, da dobimo manjši radialni temperaturni gradient in večji vzdolžni temperaturni gradient, primeren za rast 8-palčnih kristalov iz silicijevega karbida. (2) V velikosti rotacije in mehanizma za dvigovanje in znižanje gibanja velike velikosti, tako da se lonček vrti med procesom rasti kristala in se premika glede na tuljavo glede na zahteve procesa, da se zagotovi konsistenca 8-palčnega kristala in olajša rast in debelino. (3) Samodejni nadzor parametrov procesa v dinamičnih pogojih, ki ustrezajo potrebam visokokakovostnega procesa rasti posameznih kristalov.
1 mehanizem rasti kristalov PVT
Metoda PVT je priprava enojnih kristalov iz silicijevega karbida tako, da postavimo vir SIC na dnu valjastega gostega grafitnega lončka, kristal semena SiC pa je nameščen v bližini pokrova lončka. Lonček se segreje na 2 300 ~ 2 400 ℃ z indukcijo ali upornostjo radiofrekvence in je izoliran z grafitnim klobukom ozporozni grafit. Glavne snovi, ki se prenašajo iz vira SiC v kristal semen, so Si2c molekule in SiC2. Temperatura na kristalu semena je nadzorovana tako, da je nekoliko nižja kot pri spodnjem mikro-prahu in v lončku nastane osni temperaturni gradient. Kot je prikazano na sliki 1, silicijev karbidni mikro-prah sublimata pri visoki temperaturi, da tvorijo reakcijske pline različnih plinskih faznih komponent, ki dosežejo semensko kristal z nižjo temperaturo pod pogonom temperaturnega gradienta in na njem kristalizirajo, da tvorijo cilindrični ingot silicijevega karbida.
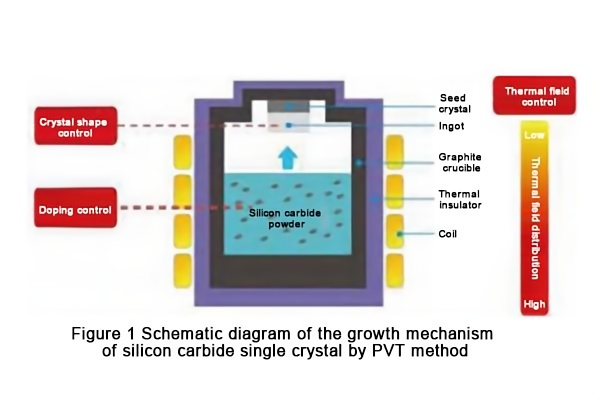
Glavne kemijske reakcije rasti PVT so:
Sic (s) ⇌ si (g)+c (s)
2Sic ⇌ in2C (g)+c (s)
2SIC ⇌ SIC2 (G)+SI (L, G)
Sic (s) ⇌ sic (g)
Značilnosti rasti PVT enojnih kristalov SIC so:
1) Obstajata dva plinsko trdna vmesnika: eden je vmesnik za plin-sic, drugi pa vmesnik za plin-kristal.
2) plinska faza je sestavljena iz dveh vrst snovi: ena je inertne molekule, vnesene v sistem; Druga je komponenta plinske faze SIMCN, ki nastane z razgradnjo in sublimacijoSic prah. Komponente plinske faze SIMCN medsebojno sodelujejo in del tako imenovanih kristalnih plinskih faznih komponent SIMCN, ki izpolnjujejo zahteve procesa kristalizacije, bo zrasel v kristal SIC.
3) In the solid silicon carbide powder, solid-phase reactions will occur between particles that have not sublimated, including some particles forming porous ceramic bodies through sintering, some particles forming grains with a certain particle size and crystallographic morphology through crystallization reactions, and some silicon carbide particles transforming into carbon-rich particles or carbon particles due to non-stoichiometric razgradnja in sublimacija.
4) Med postopkom rasti kristala se bosta zgodila dve fazni spremembi: ena je, da se trdni delci iz silicijevega karbida v prahu pretvorijo v komponente plinske faze SIMCN z netoihiometrično razgradnjo in sublimacijo, druga pa, da se plinske fazne komponente s kristalizacijo pretvorijo v delce rešetke.
2 zasnova opreme
Kot je prikazano na sliki 2, silicijev karbid enojna peč za kristalno rast v glavnem vključuje: sklop zgornjega pokrova, sklop komore, ogrevalni sistem, mehanizem vrtenja v krmi, mehanizem za dvigovanje spodnjega pokrova in električni nadzor.

2.1 Ogrevalni sistem
Kot je prikazano na sliki 3, ogrevalni sistem sprejme indukcijsko ogrevanje in je sestavljen iz indukcijske tuljave, aGrafitni lonček, izolacijski sloj (togi občutek, mehko) itd. Ko srednje frekvenca izmenični tok prehaja skozi večkratno indukcijsko tuljavo, ki obdaja zunanjost grafitnega lončka, bo v grafitnem lončku nastalo inducirano magnetno polje iste frekvence, ki ustvarja inducirano elektromotivno silo. Ker ima visoko-čistosti grafitni lonček dobro prevodnost, se na steni lončenja ustvari inducirani tok, ki tvori vrtinčni tok. Pod delovanjem Lorentzove sile se bo inducirani tok sčasoma zbližal na zunanji steni lončka (tj. Učinek kože) in postopoma oslabil po radialni smeri. Zaradi obstoja vrtinčnih tokov nastane Joule Heat na zunanji steni longa, ki postane ogrevalni vir rastnega sistema. Velikost in porazdelitev joule toplote neposredno določata temperaturno polje v loncu, kar posledično vpliva na rast kristala.
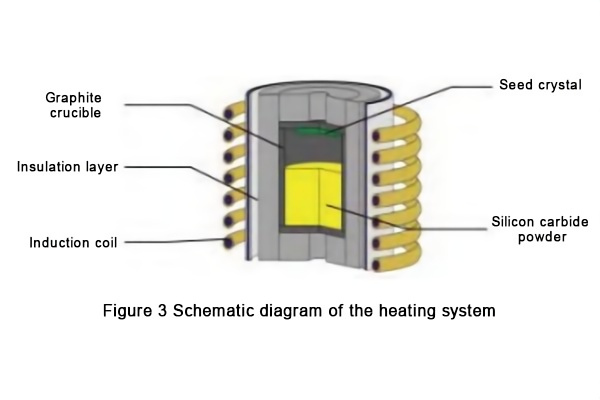
Kot je prikazano na sliki 4, je indukcijska tuljava ključni del ogrevalnega sistema. Sprejema dva sklopa neodvisnih struktur tuljav in je opremljen z zgornjimi in spodnjimi mehanizmi gibanja natančnosti. Večino električne izgube toplote celotnega ogrevalnega sistema nosi tuljava, prisilno hlajenje pa je treba izvesti. Tuljava je navita z bakreno cevjo in jo ohladi z vodo v notranjosti. Frekvenčni območje induciranega toka je 8 ~ 12 kHz. Pogostost indukcijskega ogrevanja določa globino penetracije elektromagnetnega polja v grafitnem lončku. Mehanizem gibanja tuljave uporablja mehanizem vijačnega para, ki ga poganja motor. Indukcijska tuljava sodeluje z indukcijskim napajanjem pri segrevanju notranjega grafitnega lončka za dosego sublimacije prahu. Hkrati sta moč in relativni položaj obeh sklopov tuljav nadzorovana, da se temperatura pri kristalu semena nižja kot pri spodnjem mikro moči, pri čemer tvorita osni temperaturni gradient med semenskim kristalom in prahom v krožniku ter tvorita razumen radialni temperaturni gradient v kristalu silikonskega karbida.

2.2 Mehanizem vrtenja lončka
Med rastjo velike velikostiEnojni kristali iz silicijevega karbida, lonček v vakuumskem okolju votline se vrti v skladu z zahtevami procesa, gradientno toplotno polje in stanje nizkega tlaka v votlini pa je treba ohraniti stabilno. Kot je prikazano na sliki 5, se za doseganje stabilnega vrtenja lončka uporablja motorični prestavni par. Za doseganje dinamičnega tesnjenja vrtljive gredi se uporablja struktura tesnjenja magnetne tekočine. Tesnilo z magnetno tekočino uporablja vrteče se vezje magnetnega polja, ki nastane med magnetom, čevelj magnetnega droga in magnetnim rokavom, da trdno adsorbira magnetno tekočino med konico čevljev pola in rokavom, da tvori O-obročni tekoči obroč, ki popolnoma blokira vrzel, da doseže namen tesnjenja. Ko se vrtilno gibanje prenaša iz atmosfere v vakuumsko komoro, se uporablja tekoča dinamična naprava za tesnjenje o-obroča za premagovanje slabosti lahkega obrabe in nizke življenjske dobe trdnega tesnjenja, tekoča magnetna tekočina pa lahko napolni celoten zaprti prostor, s čimer blokira vse kanale, ki lahko puščajo zrak in dosežejo ničelno puščanje v dveh procesih in odpadku v dve procesi in odmrznjeni. Podpora za magnetno tekočino in lonček sprejmeta strukturo hlajenja vode, da se zagotovi visokotemperaturna uporabnost magnetne tekočine in podpornega podpora ter doseže stabilnost stanja toplotnega polja.

2.3 Mehanizem za dvigovanje nižjega pokrova
Mehanizem za dvigovanje spodnjega pokrova je sestavljen iz pogonskega motorja, krogličnega vijaka, linearnega vodnika, dvižnega nosilca, pokrova peči in peči. Motor poganja nosilec peči, priključen na vijačni vodnik skozi reduktor, da uresniči gibanje navzgor in navzdol spodnjega pokrova.
Mehanizem za dvigovanje spodnjega pokrova olajša namestitev in odstranjevanje velikih lončkov, kar je še pomembneje, zagotavlja zanesljivost tesnjenja spodnjega pokrova peči. Med celotnim postopkom ima komora faze spreminjanja tlaka, kot so vakuum, visok tlak in nizki tlak. Stanje stiskanja in tesnjenja spodnjega pokrova neposredno vpliva na zanesljivost procesa. Ko tesnilo ne uspe pri visoki temperaturi, bo celoten postopek odstranjen. Skozi napravo za krmiljenje in omejitev motorja se tesnost sklopa spodnjega pokrova in komore nadzira, da se doseže najboljše stanje stiskanja in tesnjenja tesnilnega obroča peči, da se zagotovi stabilnost procesnega tlaka, kot je prikazano na sliki 6.
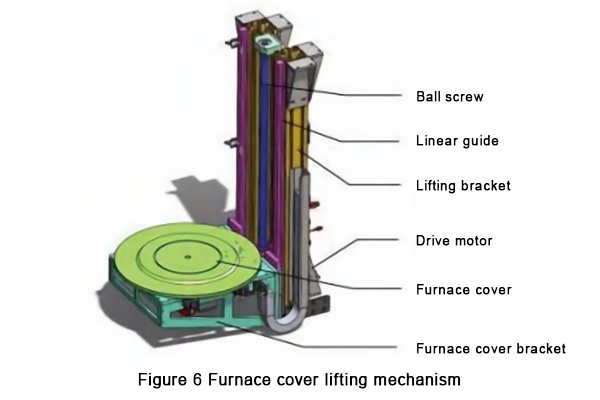
2.4 Električni krmilni sistem
Med rastjo kristalov silicijevega karbida mora električni nadzorni sistem natančno nadzorovati različne parametre procesa, predvsem vključno z višino položaja tuljave, hitrostjo vrtenja lončkov, ogrevalno močjo in temperaturo, različnim posebnim vnosom plina in odpiranjem proporcionalnega ventila.
Kot je prikazano na sliki 7, krmilni sistem uporablja programabilni krmilnik kot strežnik, ki je povezan s servo gonilnikom prek vodila, da uresniči nadzor gibanja tuljave in lončka; Povezan je s temperaturnim regulatorjem in regulatorjem pretoka prek standardnega MoBUSRTU, da uresniči nadzor temperature, tlaka in posebnega procesnega pretoka plina v realnem času. Vzpostavi komunikacijo s konfiguracijsko programsko opremo prek Etherneta, izmenjuje podatke o sistemu v realnem času in prikazuje različne informacije o parametrih procesov na gostiteljskem računalniku. Operaterji, procesno osebje in menedžerji izmenjujejo informacije s krmilnim sistemom prek vmesnika človeškega stroja.

Krmilni sistem izvaja vse poljske zbiranje podatkov, analizo delovnega stanja vseh aktuatorjev in logično razmerje med mehanizmi. Programibilni krmilnik prejme navodila gostiteljskega računalnika in zaključi nadzor vsakega aktuatorja sistema. Strategija izvajanja in varnosti v meniju samodejnega procesa izvaja programirljivi krmilnik. Stabilnost programirljivega krmilnika zagotavlja stabilnost in varnost zanesljivosti delovanja menija procesa.
Zgornja konfiguracija vzdržuje izmenjavo podatkov s programirljivim krmilnikom v realnem času in prikazuje podatke polja. Opremljena je z vmesniki za operacije, kot so nadzor ogrevanja, nadzor tlaka, nadzor plinskega vezja in nadzor motorja, na nastavitvenem vmesniku pa se lahko spremenijo nastavitvene vrednosti različnih parametrov. Spremljanje parametrov alarma v realnem času, zagotavljanje zaslona zaslona, snemanje časa in podrobne podatke o pojavu in obnovitvi alarma. Snemanje vseh podatkov o procesih, vsebino delovanja in čas delovanja v realnem času. Nadzor fuzije različnih procesnih parametrov se realizira s pomočjo osnovne kode znotraj programirljivega krmilnika in uresničiti je mogoče največ 100 korakov procesa. Vsak korak vključuje več kot ducat parametrov procesa, kot so čas delovanja procesa, ciljna moč, ciljni tlak, pretok argona, pretok dušika, pretok vodika, položaj lončka in hitrost lonca.
3 Analiza simulacije termičnega polja
Vzpostavljen je model analize simulacije termičnega polja. Slika 8 je zemljevid temperature oblaka v rastni komori. Da bi zagotovili temperaturno temperaturo 4H-SIC enojnega kristala, se izračuna sredinska temperatura semenskega kristala 2200 ℃, robni temperatura pa 2205,4 ℃. V tem času je sredinska temperatura lončljivega vrha 2167,5 ℃, najvišja temperatura površine prahu (stran navzdol) pa 2274,4 ℃, kar tvori osni temperaturni gradient.

Radialna gradientna porazdelitev kristala je prikazana na sliki 9. Spodnji bočni temperaturni gradient semenske kristalne površine lahko učinkovito izboljša obliko kristalne rasti. Toka izračunana začetna temperaturna razlika je 5,4 ℃, celotna oblika pa je skoraj ravna in rahlo konveksna, kar lahko ustreza radialnim temperaturnim nadzorom natančnosti in enakomernosti potrebe po površini kristala semena.

Krivulja temperaturne razlike med površino surovine in površino kristala semena je prikazana na sliki 10. Sredinska temperatura površine materiala je 2210 ℃, vzdolžni temperaturni gradient 1 ℃/cm pa nastane med površino materiala in semensko kristalno površino, ki je znotraj razumnega območja.
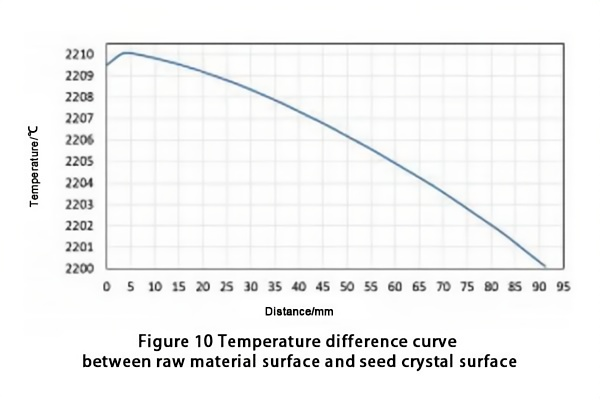
Ocenjena stopnja rasti je prikazana na sliki 11. Prehib hitrost rasti lahko poveča verjetnost napak, kot sta polimorfizem in dislokacija. Trenutna ocenjena stopnja rasti je blizu 0,1 mm/h, kar je v razumnem območju.

Z analizo in izračunom simulacije termičnega polja je ugotovljeno, da srednja temperatura in robna temperatura kristala ustrezata radialnemu temperaturnemu gradientu kristala 8 palcev. Hkrati zgornji del in dno lončka tvorita osni temperaturni gradient, primeren za dolžino in debelino kristala. Trenutna metoda ogrevanja rastnega sistema lahko ustreza rasti 8-palčnih enojnih kristalov.
4 Eksperimentalni test
Z uporabo tegaEnojna peč iz silicijevega karbida, Na podlagi temperaturnega gradienta simulacije toplotnega polja s prilagajanjem parametrov, kot so zgornja temperatura lonca, tlak v votlini, hitrost vrtenja lončkov in relativni položaj zgornje in spodnje tuljave, je bil izveden test rasti kristala iz silicijevega karbida, in 8-palčni kristal silicijevega karbida (kot je prikazano 12).

5 Zaključek
Preučevali so ključne tehnologije za rast 8-palčnih enojnih kristalov silicijevega karbida, kot so gradientno toplotno polje, mehanizem gibanja lončkov in samodejni nadzor parametrov proces. Toplotno polje v rastni komori lončkov smo simulirali in analizirali, da smo dobili idealen temperaturni gradient. Po testiranju lahko metoda indukcijskega ogrevanja z dvojnim tuljam ustreza rasti velikih velikostiKristali iz silicijevega karbida. Raziskave in razvoj te tehnologije zagotavlja tehnologijo opreme za pridobivanje 8-palčnih kristalov karbida in zagotavlja temelje opreme za prehod industrializacije silicijevega karbida s 6 do 8 centimetrov, kar izboljšuje učinkovitost rasti silicijevih karbidnih materialov in zmanjšanje stroškov.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Kitajska
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. Vse pravice pridržane.
Links | Sitemap | RSS | XML | Politika zasebnosti |
